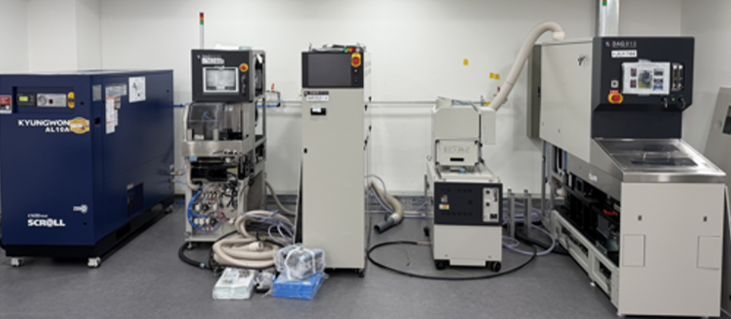
Back Grinder / Dicing Saw
Wafer thinning and precise singulation processes for advanced packaging structures. These processes directly influence residual stress, warpage, and crack initiation behavior.
- Wafer thickness control
- Stress-sensitive back-end processing
- Pre-conditioning for reliability tests

Die Bonder
High-precision die attach system enabling multi-chip and heterogeneous integration under controlled bonding conditions.
- Die placement accuracy
- Bonding-induced stress control
- Advanced package assembly

Wire Bonder
Electrical interconnection equipment used to study wire deformation, fatigue, and interfacial reliability in packaged devices.
- Wire deformation and fatigue analysis
- Interfacial reliability evaluation
- Electrical interconnect integrity